2.1 最大值
2.1.1 击穿电压
当 V GS =0V,SiC MOSFET处于关断状态并承受外加电压 V DS 时,会存在从源极到漏极的微小电流,称为漏电流 I DSS 。 I DSS 受外加电压 V DS 和芯片结温 T J 的影响,如图2-1所示。当 V DS 较低时, I DSS 仅有几百pA到几十nA,此时SiC MOSFET处于可靠关断状态;随着 V DS 的升高, I DSS 也逐渐缓慢增大;当 V DS 大于1650V左右后, I DSS 迅速增大,此时SiC MOSFET已无法继续有效阻断电压。另外,在有效关断时, I DSS 随着 T J 的升高而增大;在有效关断的临界点, I DSS 的转折电压随着 T J 的升高而升高。
一般定义在 V GS =0V下,SiC MOSFET能够承受的使 I DSS 不超过击穿漏电流 I (BR)DSS 的最大电压为击穿电压 V (BR)DSS 。 I (BR)DSS 取值一般在100μA~5mA之间,由各厂商自行定义,部分厂商遵循器件电流等级越大, I (BR)DSS 越大的规律,部分厂商取 I (BR)DSS 为恒定值。根据图2-1可知,标称耐压1200V的SiC MOSFET实际 V (BR)DSS 为1650V左右,这是在考虑器件离散性和实际应用要求后留出的裕量。这就解释了为什么当SiC MOSFET承受短时略微超过数据手册标称 V (BR)DSS 的关断电压尖峰后不会立刻损坏,但即便如此,在使用时也需要避免其端电压超过数据手册中的标称 V (BR)DSS 。

图2-1 I DSS -V DS 特性
根据图2-1和 V (BR)DSS 的定义可知, V (BR)DSS 同样受结温 T J 的影响, V (BR)DSS 随 T J 升高而升高,如图2-2所示。这是因为随着 T J 上升,载流子的迁移率会随着晶格散射和杂质散射增加而下降,从而使击穿难度增加,击穿电压就会升高。

图2-2 V (BR)DSS -T J 特性
2.1.2 热阻抗
热阻抗包括热容和热阻两部分,热阻代表材料阻碍热量传递的能力,是传热系数的倒数,热容代表材料对热能储存的能力。热域物理量与电域物理量具有类比关系,能够帮助电源工程师理解和记忆:温度 T 、热流量 P 、热阻抗 Z th 、热阻 R th 和热容 C th 分别类比于电压 V 、电流 I 、阻抗 Z 、电阻 R 和电容 C 。
SiC MOSFET在工作时产生损耗,热量从芯片依次传递到封装外壳、散热器、环境,基于此可以建立Cauer模型,其中各层材料热阻依次连接,热容全部连接到环境参考温度,如图2-3所示。因此,Cauer模型的节点能表示各层材料的温度,具有物理意义。
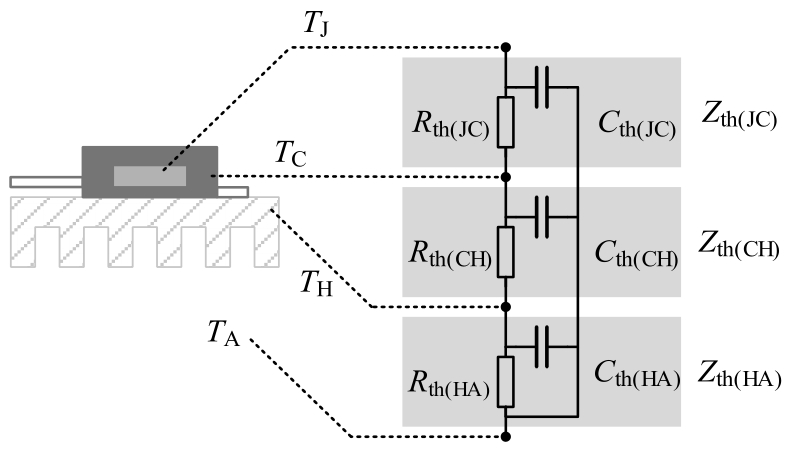
图2-3 Cauer阻抗模型
但是由于各层材料的热容和热阻难以获得,数据手册给出单脉冲和连续方波热激励下测量得到的热阻抗曲线,如图2-4所示,其横轴为脉冲宽度 t p ,纵轴为热阻抗值 Z th(JC) 。在脉冲加热阶段,各层材料吸收热量温度升高;在脉冲间歇阶段,材料向环境散热冷却。 Z th(JC) 是以利用升温阶段结束时材料的最高温度定义。
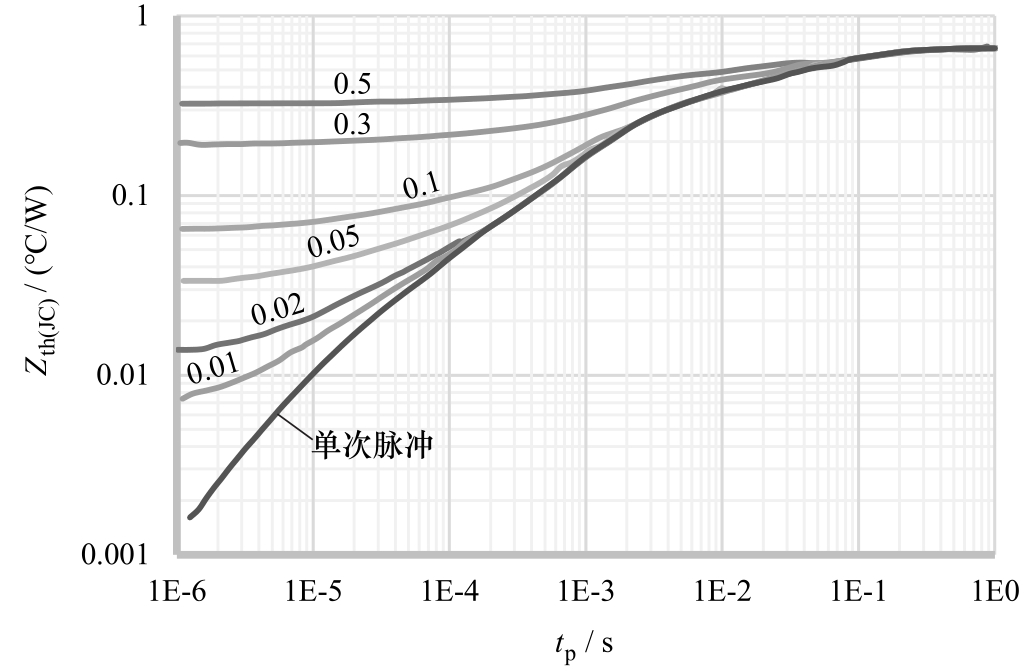
图2-4 SiC MOSFET热阻抗曲线
单脉冲下的热阻抗曲线位于最下端, t p 越短,材料加热时间较短,温升较少,则 Z th(JC) 越小。 Z th(JC) 随着 t p 增大而增大,最终趋于稳定,此时的热阻抗就是热阻值。其余曲线为脉宽为 t p 的连续方波热激励下热阻抗曲线,为一簇不同占空比 D 下的阻抗曲线。在相同 t p 下, D 越高,加热时间所占比例越高,材料温升越高,则 Z th(JC) 越高。同时随着 t p 的增加,不同 D 下的 Z th(JC) 曲线也逐渐收敛至热阻值。
部分厂商的数据手册还会基于热阻抗曲线提供Foster模型参数,如图2-5所示。Foster模型的表达式为式(2-1),可以利用其进行热仿真分析。
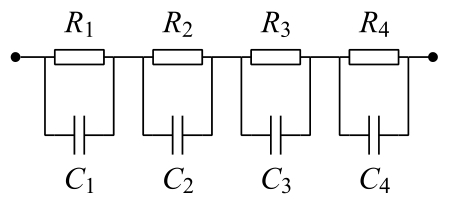
图2-5 Foster热阻抗模型

需要注意的是,Foster模型是对热阻抗曲线的数值拟合,尽管仍由热阻热容网络表示,但是定义在两个节点温度之间的热容并不具备物理意义。
2.1.3 最大耗散功率和最大漏极电流
SiC MOSFET工作时会产生损耗,当损耗和散热条件一定时,结温升高并达到稳态 T J(steady) ,遵循式(2-2),其中 T C 为管壳温度, R th(JC) 为结-壳热阻。当 T J(steady) 达到器件最高允许工作结温 T J(max) ,此时的损耗为对应管壳温度下的最大耗散功率 P tot ( T C )。

由(2-2)可知, P tot ( T C )受 T C 的影响,数据手册提供两者关系如图2-6所示。当 T C 低于25℃时, P tot ( T C )保持不变。当 T C 高于25℃时, P tot ( T C )按照式(2-2)线性下降。

图2-6 P tot ( T C ) -T C 特性
在实际应用中,器件通过散热器将热量传递到环境中,遵循式(2-3),其中 T A 为环境温度, R th(JA) 为结-环境热阻, R th(CH) 为壳-散热器热阻, R th(HA) 为散热器-环境热阻。当 T J 为最高允许工作结温 T J(max) 时,此时的损耗 P D 为对应环境温度下的最大耗散功率 P tot ( T A )。数据手册中一般不会提供 P tot ( T A )数据,这是因为 R th(CH) 和 R th(HA) 需要基于具体的变换器设计得到。

最大漏极电流分为最大连续漏极电流 I D 和最大脉冲漏极电流 I D(pulse) ,都受到最大损耗功率的限制,一般是基于 P tot ( T C )定义。
器件电流等级一般由特定 T C 下的 I D 定义,由式(2-4)计算,其中 R DS(on) ( T J(max) )为最高允许工作结温下的导通电阻:

数据手册都会提供 I D -T C 特性曲线,如图2-7所示。当 T C 低于25℃时, I D 保持不变;当 T C 高于25℃时, I D 按照式(2-4)呈曲线下降。

图2-7 I D -T C 特性
由于是单次脉冲电流, I D(pulse) 往往是 I D 的2~4倍。 I D(pulse) 不仅受 P tot ( T C )限制,还与脉冲电流的脉宽 t p 和 V DS 有关,由式(2-5)计算:

需要注意的是, I D(pulse) 不会随着 t p 和 V DS 的减小而无限制地增大,而是在任何情况下都受限于键合线的通流能力。
2.1.4 安全工作域
安全工作域即SOA(Safe Operating Area),SiC MOSFET可在其区域内安全工作,其边界是SiC MOSFET在工作时能够承受漏-源电流 I DS 和漏-源电压 V DS 的上限,具体由上文中介绍的 V (BR)DSS 、 I D 和 I D(pulse) 加以限制。SiC MOSFET必须工作在安全工作域内,否则会导致寿命缩短或直接损坏。数据手册一般提供 T C 为25℃时的安全工作域,以双对数坐标图呈现,如图2-8所示。
安全工作域的边界由4条线段组成,分别为A、B、C、D。

图2-8 安全工作域 T C =25℃
1.线段A为 R DS(on) 限制
A代表 R DS(on) 的限制,高于A的区域无法成为SiC MOSFET的工作点,利用 T J(max) 下的 R DS(on) 得到,在双对数坐标中表示为

2.线段B为 V (BR)DSS 限制
B代表 V (BR)DSS 的限制,即耐压限制。
3.线段C为 I D(pulse) 限制
C代表由键合线通流能力所确定的 I D(pulse) 的限制。
4.线段D为 P tot ( T C )限制
D代表 P tot ( T C )的限制,由根据式(2-5)得到的不同 t p 下的一簇 I D(pulse) ( V DS , t p )线段表示,在双对数坐标中表示为

在实际工作中,SiC MOSFET的 T C 远高于25℃,图2-8中的安全工作域不再适用,需要进行换算后再用于设计。 T C 对A、B、C这三个限制条件没有影响,仅需要对D进行换算,接下来以将 t p =10μs从 T C =25℃换算至 T C =100℃为例。
由图2-8可知, P tot (25℃)=8.5A×1200V=10.2kW。当 t p 固定时, Z th(JC) ( t p )不受 T C 的影响,则

进而由(2-5)得到在 T C =100℃时, t p =10μs限制条件与B和C的交点分别为(97V,70A)和(1200V,5.67A),将两点连接即为换算后的D限制条件,在图2-8中用虚线表示。


