2.3 动态特性
2.3.1 结电容
SiC MOSFET的结构如图2-16所示,在其栅极、漏极、源极之间存在寄生电容。
1.栅-源电容 C GS
由沟道-栅极氧化物电容 C channel 和栅极-源极平行结构电容 C pp 并联构成。 C pp 受栅-源极间绝缘材料、距离、交叠面积的影响,为典型平行板电容,不受端电压的影响。 C channel 受 V DS 、沟道长度的影响,为非线性电容。沟道耗散区随着 V DS 的升高而扩展, C channel 也随之减小,但变化非常微小。
2.栅-漏电容 C GD
由氧化层静电电容 C field-oxide 和MOS分界面耗散电容 C depletion 串联构成。 C field-oxide 为恒定值, C depletion 受 V DS 影响,随着 V DS 升高而降低。
3.漏-源电容 C DS
主要为漏-源pn结耗散层电容,随着 V DS 升高而降低。
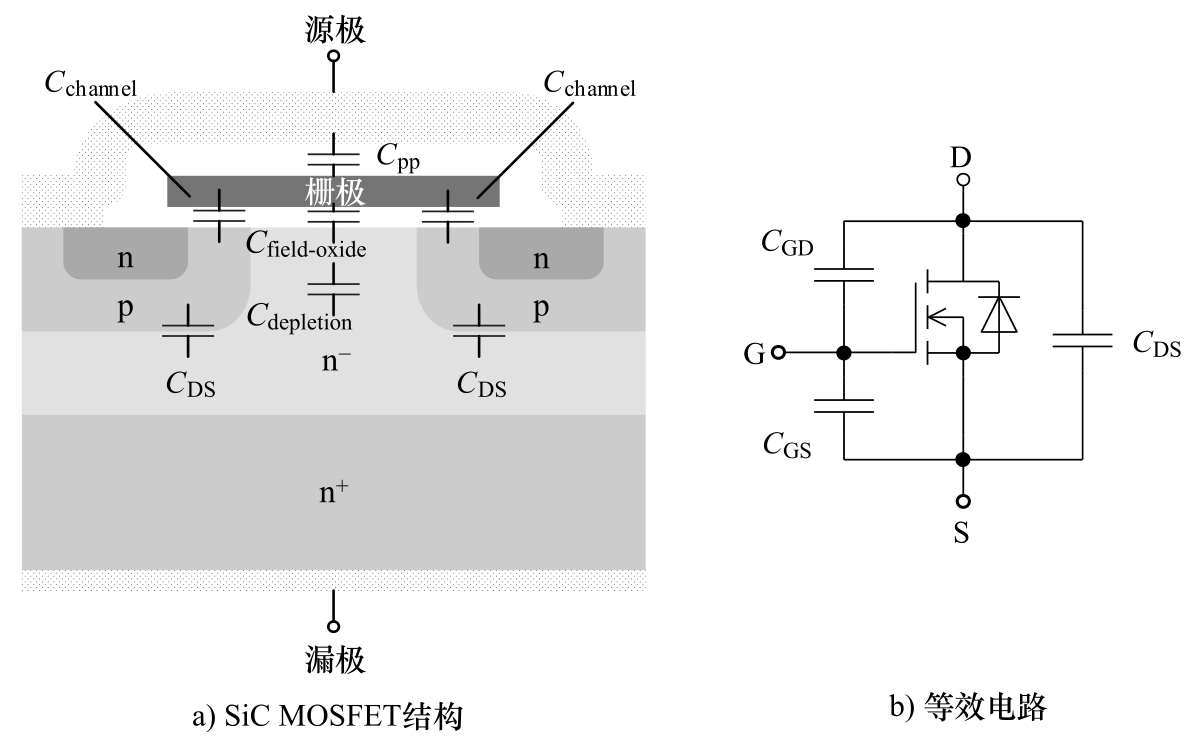
图2-16 SiC MOSFET结电容
在数据手册中结电容以输入电容 C iss 、输出电容 C oss 和反向输出电容 C rss (也称为米勒电容)给出,其定义分别为式(2-9)、式(2-10)和式(2-11)

由于 C iss 、 C oss 和 C rss 都具有受 V DS 的影响的成分,呈现出非线性电容的特征,如图2-17所示。当 V DS 较低时,结电容随着 V DS 升高而减小,其中 C oss 和 C rss 减小得更加明显;当 V DS 较高时,结电容基本保持不变,耗散区在 V DS 达到一定值后不再变化。同时 C GS >> C GD , C iss 由 C GS 主导; C DS >> C GD , C oss 由 C DS 主导。
需要注意的是,在数据手册中给出的结电容数据和 C-V 特性曲线都是在 V GS =0V时测得的,即SiC MOSFET在关断状态下的 C-V 特性。而当 V DS 小于 V GS 时, C GS 和 C GD 将随着 V GS 的升高显著增大。故仅利用数据手册给出的 C-V 曲线表述SiC MOSFET的开关过程是不充分的。
2.3.2 开关特性
在大部分功率变换器中,SiC MOSFET的开关换流过程都可以基于电感负载电路进行描述,如图2-18所示。 L 为负载电感, C Bus 为母线电容, R G 为驱动电阻, L Loop 为主功率换流回路电感, L DRV 为驱动回路电感,Q H 和Q L 为SiC MOSFET,VD H 和VD L 为 Q H 和 Q L 的体二极管。为了简化对开关过程的分析,需要将 L DRV 忽略,但为了获得更有意义的波形,通过仿真获取波形时将 L DRV 考虑在内。
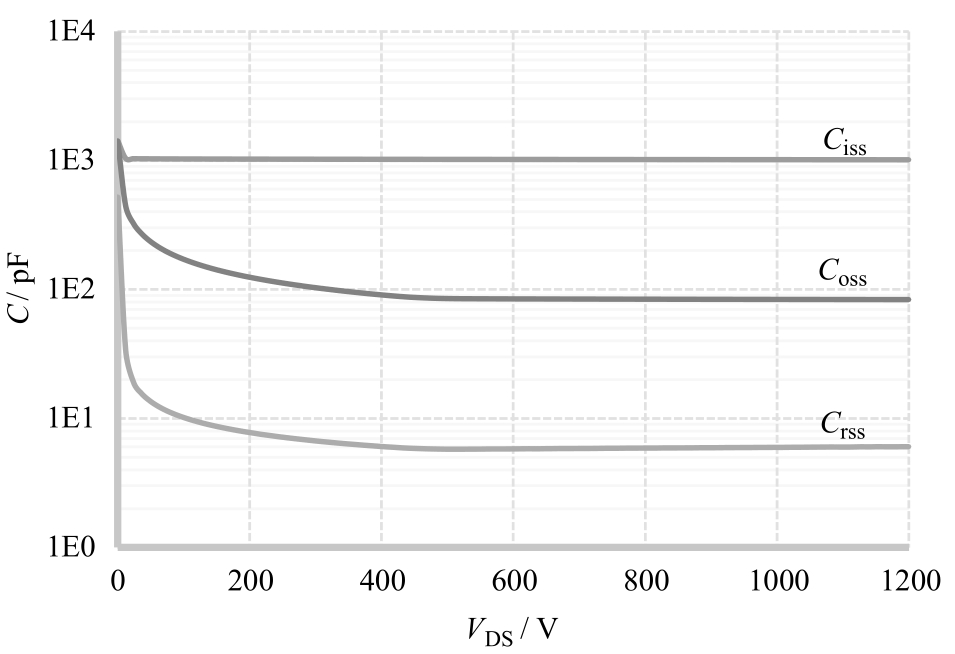
图2-17 C-V 特性
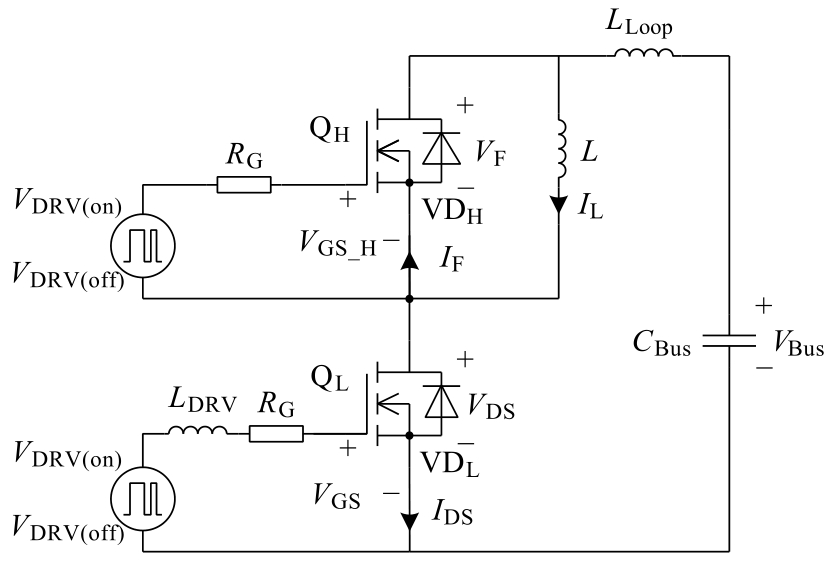
图2-18 电感负载电路
2.3.2.1 开通过程和体二极管反向恢复过程
SiC MOSFET开通过程和体二极管反向恢复过程的仿真波形和SiC MOSFET开通过程电路分别如图2-19和图2-20所示。
1.~ t 0
Q L 的 V GS 为关断驱动电压 V DRV(off) ,处于关断状态, I DS 为零, V DS 承受母线电压 V Bus ;Q H 的 V GS_H 为 V DRV(off) ,负载电流 I L 通过VD H 和 L 进行续流,压降为 V F 。
2. t 0 ~ t 1
t
0
时刻驱动电压由
V
DRV(off)
迅速变为开通驱动电压
V
DRV(on)
,驱动电路通过驱动电流
I
G
向
C
iss
充电,可细分为
 向
C
GS
充电和
向
C
GS
充电和
 向
C
GD
充电
向
C
GD
充电

由于此时SiC MOSFET仍然处于关断状态, V DS 保持 V Bus 不变,故 C GS 和 C GD 保持恒定,且d V GS /d t 和d V GD /d t 相等,联立式(2-12)和式(2-13)可得

解得

t 1 时刻 V GS 达到SiC MOSFET的阈值电压 V GS(th) , t 0 ~ t 1 称为开通延时 t d(on) 。
3. t 1 ~ t 2
V GS 超过 V GS(th) ,SiC MOSFET开始导通,由于处于饱和状态, I channel 受 V GS 控制并由式(2-16)得到,其中K为由器件半导体参数决定的系数

需要注意的是
I
channel
由
I
DS
、
 和
和
 三个部分构成。由于此时
V
DS
仍然较高,故
C
GS
和
C
GD
较小,同时d
V
DS
/d
t
较低,故在
I
channel
中
I
DS
占主导
三个部分构成。由于此时
V
DS
仍然较高,故
C
GS
和
C
GD
较小,同时d
V
DS
/d
t
较低,故在
I
channel
中
I
DS
占主导

随着 I L 不断换流至Q L , I DS 迅速上升,d I DS /d t 在主功率换流回路电感 L Loop 上产生压降,导致 V DS 下跌

由于 C GD << C GS ,故Δ V DS 对 V GS 的影响很小, V GS 仍然基本遵循式(2-14)

结合式(2-16)、式(2-17)、式(2-18)、式(2-19)可知d I DS /d t 越来越大,Δ V DS 也随之增大。
当 I DS 超过负载电流后,VD H 进行反向恢复,使得 I DS 出现过冲, V GS 也持续升高。
4. t 2 ~ t 3
t
2
时刻,
I
DS
达到峰值附近,VD
H
开始关断,
V
DS
快速下降,
I
channel
仍然由
I
DS
、
 和
和
 三个部分构成。由于d
V
DS
/d
t
较高,同时当
V
DS
较低时,
C
DS
和
C
GD
显著增大,导致
三个部分构成。由于d
V
DS
/d
t
较高,同时当
V
DS
较低时,
C
DS
和
C
GD
显著增大,导致
 和
和
 接近甚至超过
I
DS
,此时测试得到的
I
DS
明显小于实际的
I
channel
接近甚至超过
I
DS
,此时测试得到的
I
DS
明显小于实际的
I
channel

由于SiC MOSFET具有显著的DIBL,导致 V GS(th) 随着 V DS 的下降而升高。根据式(2-16),为了确保流过 I channel ,就需要对 C GS 进行充电,抬高 V GS 。这一点与Si SJ-MOSFET明显不同,在此阶段,其 V GS 保持恒定, I G 仅对 C GD 充电,称为米勒平台(Miller Plateau)。由于SiC MOSFET的 V GS 缓慢上升,故称为米勒斜坡(Miller Ramp)。
由于
 ,则
,则

这说明d
V
DS
/d
t
受
 对
C
GD
充电速度的控制。当
V
DS
较高时,
C
GD
基本不变,当
V
DS
较低时,
C
GD
随着
V
DS
的降低显著迅速增大,特别是
V
GD
<0V时。这就导致d
V
DS
/d
t
在
V
DS
较高时基本不变,在
V
DS
较低时显著变缓。
对
C
GD
充电速度的控制。当
V
DS
较高时,
C
GD
基本不变,当
V
DS
较低时,
C
GD
随着
V
DS
的降低显著迅速增大,特别是
V
GD
<0V时。这就导致d
V
DS
/d
t
在
V
DS
较高时基本不变,在
V
DS
较低时显著变缓。
同时, I DS 进行衰减振荡,在 V DS 产生对应的波动,进而通过 C GD 的耦合作用使得 V GS 发生振荡,三者振荡频率相同。
5. t 3 ~
t 3 时刻, V DS 下降至导通压降 V DS(on) ,开通过程结束。 V GS 在驱动电路的作用下达到 V DRV(on) 。
Q L 开通过程中,VD H 由正向导通切换为反向阻断时,由于需要复位载流子以恢复空间电荷区,二极管电流的导通电流会先降至零,随后产生反向电流再衰减为零,即SiC MOSFET二极管反向恢复过程,具体如下:
1.~ t 1
VD H 正向导通,导通电流 I F 为 I L ,端电压 V F 为VD H 的导通压降。
2.

t 1 时刻Q L 开通, I F 以d i /d t 的速度从 I L 下降至零, V F 随着 I F 的降低而升高,此时体二极管中仍有大量载流子。
3.

I F 反向并增大,起到扫除电荷的作用,载流子浓度开始降低。由于载流子浓度依旧很高,体二极管保持导通状态。
4.

载流子浓度继续降低,二极管不足以维持导通状态,开始承受反向电压, I F 变化率逐渐减小。
5.

I F 达到反向峰值 I RRM 。
6.

由于载流子浓度不足以维持反向电流, I F 由 I RRM 逐渐降低至零。在此过程中, V F 发生振荡。
 时长为
t
d
,
时长为
t
d
,
 时长为
t
f
,反向恢复时间为
t
rr
,反向恢复电荷为
Q
rr
时长为
t
f
,反向恢复时间为
t
rr
,反向恢复电荷为
Q
rr


图2-19 SiC MOSFET开通过程
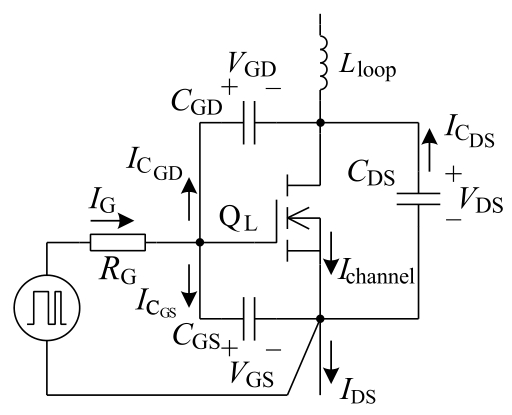
图2-20 SiC MOSFET开通过程电路
2.3.2.2 关断过程
SiC MOSFET关断过程的仿真波形和关断过程电路分别如图2-21和图2-22所示。

图2-21 SiC MOSFET关断过程
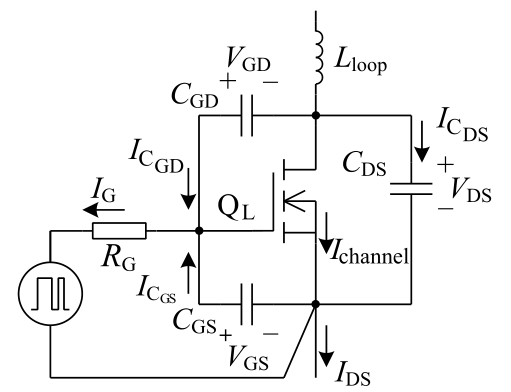
图2-22 SiC MOSFET关断过程电路
1.~ t 0
Q L 的 V GS 为 V DRV(on) ,处于导通状态, I DS 为负载电流 I L , V DS 为导通压降 V DS(on) ; D H 处于关断状态,承受母线电压 V Bus 。
2. t 0 ~ t 1
t
0
时刻驱动电压由
V
DRV(on)
迅速变为
V
DRV(off)
,驱动电路通过驱动电流
I
G
对
C
iss
放电,可细分为
 对
C
GS
放电和
对
C
GS
放电和
 对
C
GD
放电
对
C
GD
放电

由于此时Q L 仍然处于导通状态, I DS 保持 I L 不变, V GS 下降导致 R DS(on) 增加,使得 V DS(on) 有所上升。由于 V DS(on) 变化很小,故 C GS 和 C GD 保持恒定,且d V GS /d t 和d V GD /d t 相等,可得

t 1 时刻之前, V DS 和 I DS 没有明显变化, t 0 -t 1 称为开通延时 t d(on) 。
这里需要注意的是,尽管式(2-26)和式(2-15)形式相同,但由于Q L 处于导通状态, t d(off) 阶段的 C GD 显著大于 t d(on) 阶段的 C GD 。同时 t d(off) 阶段 V GS 下降幅度往往接近或大于 t d(on) 阶段 V GS 上升幅度,故 t d(off) 比 t d(on) 时长更长一些。
3. t 1 ~ t 2
t
1
时刻,Q
L
进入饱和,
V
DS
开始升高。则
D
H
端电压下降,
I
L
中的一部分换流至VD
H
,对其结电容放电。与开通过程
t
2
~
t
3
阶段
V
DS
下降类似,此时
V
DS
上升速度同样受
 的控制。随着
V
DS
的升高,
C
GD
显著降低,故d
V
DS
/d
t
不断增大,故
I
DS
也不断降低。在此期间,
I
channel
遵循式(2-16),在
I
DS
下降和DIBL效应的共同作用下,
V
GS
缓慢下降,成为米勒斜坡。
的控制。随着
V
DS
的升高,
C
GD
显著降低,故d
V
DS
/d
t
不断增大,故
I
DS
也不断降低。在此期间,
I
channel
遵循式(2-16),在
I
DS
下降和DIBL效应的共同作用下,
V
GS
缓慢下降,成为米勒斜坡。
需要注意的是
I
DS
由
I
channel
、
 和
和
 三个部分构成,由于
V
DS
上升,
三个部分构成,由于
V
DS
上升,
 对
C
GD
放电、
对
C
GD
放电、
 对
C
DS
充电,此时测试得到的
I
DS
大于实际的
I
channel
对
C
DS
充电,此时测试得到的
I
DS
大于实际的
I
channel

4. t 2 ~ t 3
t
2
时刻,
V
DS
达到
V
Bus
,
D
H
开始导通。
I
L
快速向
D
H
换流,
I
DS
快速下降,依然由
I
channel
、
 和
和
 三个部分构成。
I
channel
遵循式(2-16),到
t
3
时刻,
V
GS
降低至
V
GS(th)
,
I
channel
降低至零。同开通过
t
1
~
t
2
阶段
I
DS
上升类似,此时
I
DS
下降速度同样受
三个部分构成。
I
channel
遵循式(2-16),到
t
3
时刻,
V
GS
降低至
V
GS(th)
,
I
channel
降低至零。同开通过
t
1
~
t
2
阶段
I
DS
上升类似,此时
I
DS
下降速度同样受
 的控制。
的控制。
同时,基于式(2-18),快速下降的 I DS 在 L Loop 上的压降使得 V DS 出现电压过冲。
5. t 3 ~
Q L 完全关断, V GS 在驱动电路的作用下达到 V DRV(off) 。 I DS 衰减振荡至零,在 V DS 产生对应的波动,进而通过 C GD 的耦合作用使得 V GS 发生振荡,故三者振荡频率相同。
2.3.2.3 开关能量
一般认为开关能量是SiC MOSFET在开关过程中
I
DS
和
V
DS
的交叠产生的,通过对两者乘积进行积分计算得到。然而在开关过程中,只有沟道电流
I
channel
才会产生损耗。根据之前对开关过程的讲解,
I
DS
和
I
channel
并不是相等的,在开通和关断过程中分别为式(2-28)和式(2-29),其中
 为
C
oss
的充放电电流
为
C
oss
的充放电电流

故用
I
DS
计算开关能量会使开通能量
E
on
偏小,使关断能量
E
off
偏大。由于
I
channel
和
I
DS
的偏差电流
 用于对
C
oss
充放电,对应能量
E
oss
即为开关能量计算偏差
[10]
。则开关能量可由以下公式计算
用于对
C
oss
充放电,对应能量
E
oss
即为开关能量计算偏差
[10]
。则开关能量可由以下公式计算

 和
和
 、
、
 和
和
 分别为开通能量和关断能量积分起始点,各厂商使用的起始点并不统一。
E
on
的积分边界有0.1
V
GS
~0.03
V
DS
和0.1
I
DS
~0.1
V
DS
,
E
off
的积分边界有0.9
V
GS
~0.01
I
DS
和0.1
V
DS
~0.1
I
DS
,两者的主要区别在于是否把开通、关断延时阶段的能量看作开关损耗的一部分。由于在此阶段能量很小,故两种边界的计算结果相差很小。另外需要注意,各厂商数据手册中提供的开关能量并未利用
E
oss
进行修正。
分别为开通能量和关断能量积分起始点,各厂商使用的起始点并不统一。
E
on
的积分边界有0.1
V
GS
~0.03
V
DS
和0.1
I
DS
~0.1
V
DS
,
E
off
的积分边界有0.9
V
GS
~0.01
I
DS
和0.1
V
DS
~0.1
I
DS
,两者的主要区别在于是否把开通、关断延时阶段的能量看作开关损耗的一部分。由于在此阶段能量很小,故两种边界的计算结果相差很小。另外需要注意,各厂商数据手册中提供的开关能量并未利用
E
oss
进行修正。
2.3.3 栅电荷
对SiC MOSFET进行开关控制时驱动电路需要对其 C iss 充放电,充放电的电荷量为栅电荷 Q G ,可通过对开关过程中的栅极驱动电流 I G 积分得到。 Q G 代表对驱动能量的需求, Q G 越小,驱动损耗越小。
为了提高测试精度、简化积分计算,通常使用恒流源 I con 对被测试管进行驱动。由于是恒流源驱动,将 V GS 波形横轴时间 t 乘以 I con ,就得到了 V GS -Q G 曲线。如图2-23所示采用恒流源驱动时SiC MOSFET的 Q G 测试波形和对应的 V GS -Q G 曲线。
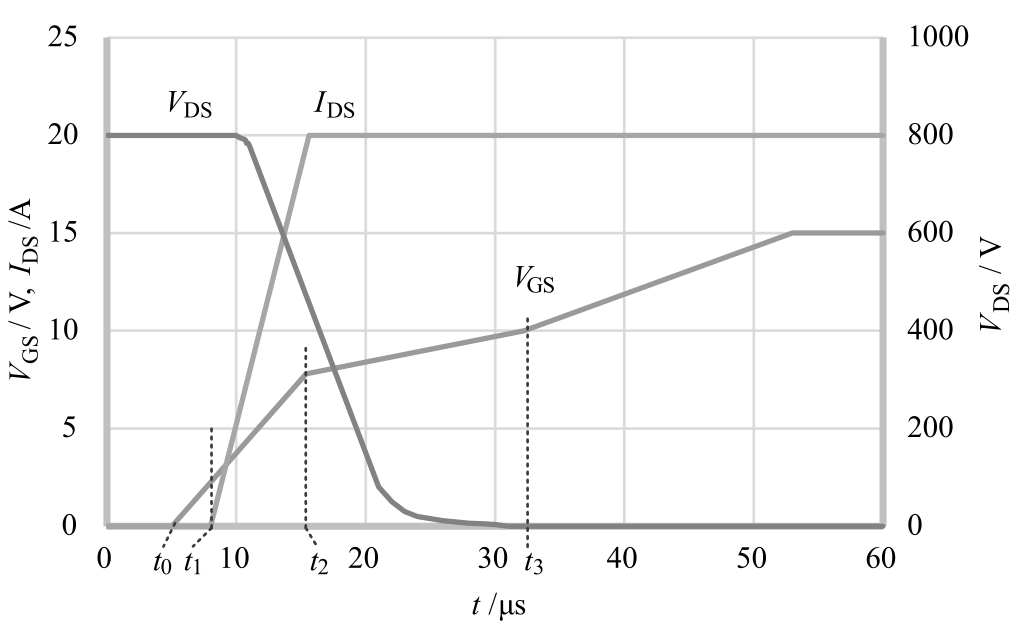
图2-23 SiC MOSFET恒流源驱动 Q G 测试波形
1. t 0 ~ t 1
I G 对 C iss 恒流充电,由于 V DS 不变, C iss 保持恒定, V GS 由0V线性上升至 V GS(th) 。
2. t 1 ~ t 2
V GS 超过 V GS(th) , I DS 由0A增大, V DS 下降, C iss 保持不变, V GS 保持线性上升。
3. t 2 ~ t 3
当 I DS 达到 I set 后, V DS 下降至较低值,由于DIBL效应,SiC MOSFET进入米勒斜坡, V GS 缓慢上升。故在此阶段 I G 不仅需要对 C rss 充电,还需要同时对 C GS 充电。
4. t 3 ~
SiC MOSFET处于开通状态, V GS 线性上升至 V GS(on) 。此阶段 V GS 上升的斜率小于 t 0 ~ t 2 阶段,这是由于SiC MOSFET在开通状态下 C GS 和 C GD 随着 V GS 的升高显著增加。


