4.2 2D集成技术
前提条件:以下定义均以基板的上表面安装元器件为准,对于基板下表面安装元器件的情况,只需将基板做镜像反转,即可采用同样的定义来判断。在后面描述的2D集成、2D+集成、2.5D集成、3D集成、4D集成5种类别的定义中,均采用此前提条件。
4.2.1 2D集成的定义
2D集成又称平面集成,是指在基板的表面水平安装所有芯片和无源元器件的集成方式,如图4-2所示。
2D集成的定义:以基板上表面的左下角为原点,基板上表面所处的平面为XY平面,基板法线为Z轴,创建坐标系。物理结构:所有芯片和无源元器件均安装在基板平面,芯片和无源元器件与XY平面直接接触,基板上的布线和过孔均位于XY平面下方。电气连接:均需要通过基板(除了极少数通过键合线直接连接的键合点)。
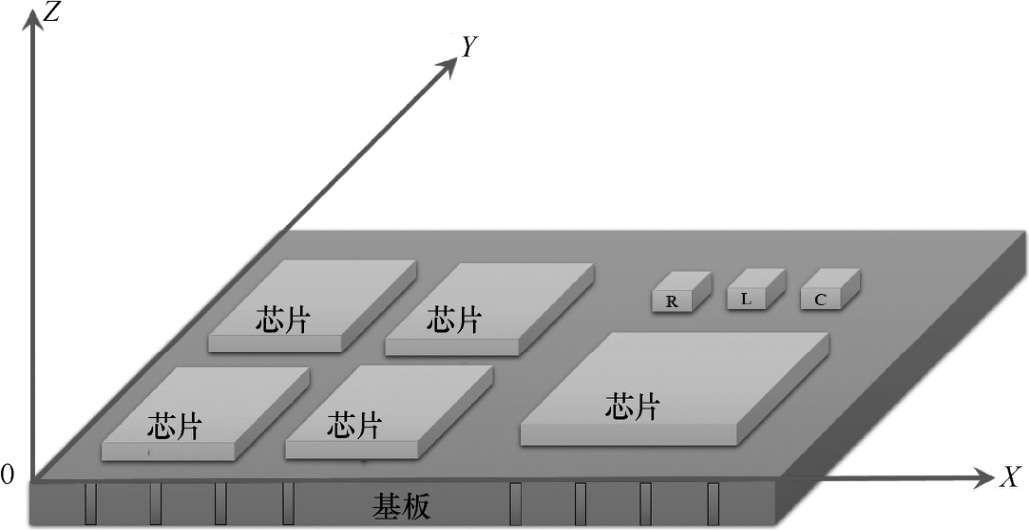
图4-2 2D集成定义示意图
4.2.2 2D集成的应用
我们最常见的2D集成技术应用于MCM、部分SiP以及PCB中。
1.MCM
MCM(多芯片模块)是将多个裸芯片高密度安装在同一基板上构成一个完整的部件。
在传统的封装领域,所有的封装都是面向元器件的,为芯片服务,起到保护芯片、尺度放大和电气连接的作用,是没有任何集成的概念的。随着MCM的兴起,封装中才有了集成的概念,封装也发生了本质的变化,MCM将封装的概念由芯片转向模块、部件或者系统。
MCM一般分为以下3种类型。
(1)MCM-L(Multi Chip Module-Laminate)是采用多层印制电路板制成的多芯片模块。MCM-L制造工艺较为成熟,生产成本较低,因芯片的安装方式和基板的结构有限,高密度布线困难,因此,电性能相对较差,主要用于工作频率30 MHz以下的产品。
(2)MCM-C(Multi chip Module-Ceramic)是采用厚膜技术和高密度多层布线技术在陶瓷基板上制成的多芯片模块。MCM-C主要用于工作频率30 ~ 500 MHz的高可靠性产品。
(3)MCM-D(Multi Chip Module-Deposited Thin Film)采用薄膜技术将金属材料淀积到陶瓷或硅、铝基板上,光刻出信号线、电源线地线,并依次做成多层基板。主要用在工作频率500 MHz以上的高性能产品中,具有组装密度高、信号通道短、寄生效应小、噪声小等优点。
2.2D集成的SiP
2D集成的SiP,其工艺路线和MCM非常相似,与MCM主要的区别在于2D集成的SiP规模比MCM大,并且能够形成独立的系统,如图4-3所示。首先制作有机基板或者高密度陶瓷基板,然后在此基础上进行封装和测试。

图4-3 2D集成的SiP


