4.4 2.5D集成技术
4.4.1 2.5D集成的定义
2.5D顾名思义是介于2D和3D之间,通常是指既有2D的特点,又有部分3D特点的一种维度,现实中并不存在2.5D这种维度。
2.5D集成定义示意图如图4-8所示。以基板上表面的左下角为原点,基板上表面所处的平面为XY平面,基板法线为Z轴,创建坐标系。物理结构:所有芯片和无源元器件均位于XY平面上方,至少有部分芯片和无源元器件安装在中介层上,在XY平面的上方有中介层的布线和过孔,在XY平面的下方有基板的布线和过孔。电气连接:中介层可提供位于中介层上的芯片的电气连接。

图4-8 2.5D集成定义示意图
2.5D集成在芯片和基板之间插入中介层,中介层上面有布线和过孔,在中介层上安装芯片和无源元器件。此外,也可能会有部分芯片和无源元器件直接安装在基板上。
4.4.2 2.5D集成的应用
2.5D集成的关键在于中介层,一般会有几种情况:①中介层是否采用硅转接板;②中介层是否采用TSV技术;③采用其他材质的转接板作为中介层。在硅转接板上,穿越中介层的过孔被称为TSV,在玻璃转接板穿越中介层的过孔被称为TGV。
1.硅中介层有TSV的2.5D集成
硅中介层有TSV的集成是最常见的一种2.5D集成技术,芯片通常通过MicroBump和中介层相连接,作为中介层的硅基板采用Bump和基板相连,硅基板表面通过RDL布线,TSV作为硅基板上下表面电气连接的通道,这种2.5D集成适合芯片规模比较大,引脚密度高的情况,芯片一般以倒装焊形式安装在硅基板上。硅中介层有TSV的2.5D集成示意图如图4-9所示。

图4-9 硅中介层有TSV的2.5D集成示意图
2.硅中介层无TSV的2.5D集成
硅中介层无TSV的2.5D集成示意图如图4-10所示,有一个面积较大的裸芯片直接安装在基板上,该芯片和基板的连接可以采用键合线或倒装焊两种方式,大芯片上方面积较大,可以安装多个较小的裸芯片,但小芯片无法直接连接到基板上,需要插入一块中介层,在中介层上方安装多个裸芯片,中介层上有RDL布线,可将芯片的信号引出到中介层的边沿,然后通过键合线连接到基板。这类中介层通常不需要TSV,只需要通过上表面的布线进行电气互连,利用硅基板的高密度特性,提高互联密度,硅基板上表面可进行多层布线(一般不大于3层),中介层采用键合线与封装基板连接。
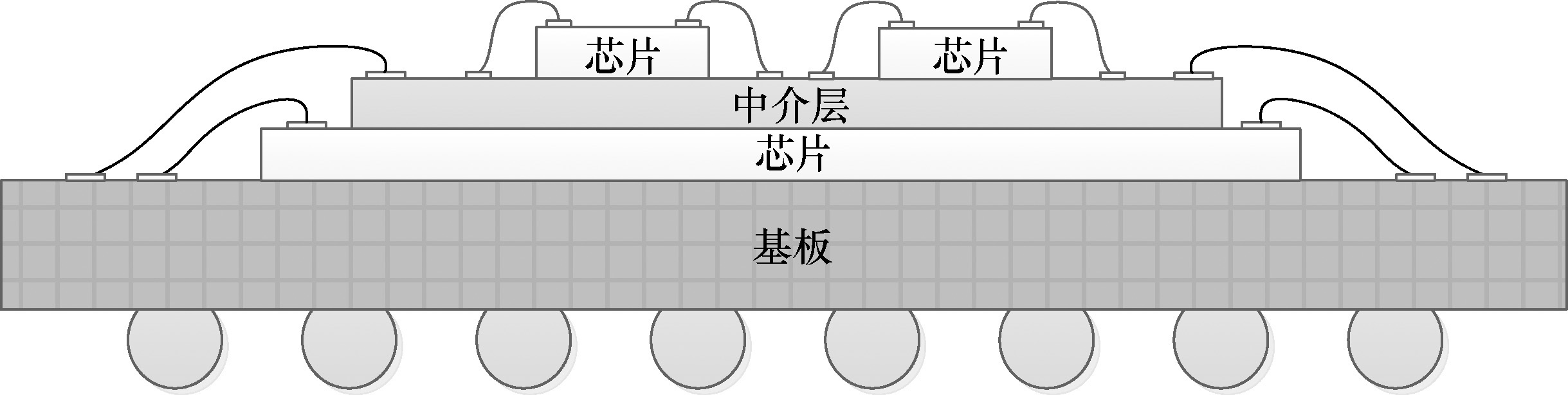
图4-10 硅中介层无TSV的2.5D集成示意图
3.采用其他材质作为中介层的2.5D集成
在玻璃转接板上,穿越整个中介层的过孔被称为TGV(Through Glass Via),在陶瓷转接板上,穿越整个中介层的过孔被称为TCV(Through Ceramic Via)。
玻璃材料和陶瓷材料没有自由移动的电荷,介电性能优良,热膨胀系数与硅接近,以玻璃或陶瓷材料替代硅材料技术可以避免TSV绝缘性不良的问题,是理想的2.5D集成解决方案。TGV、TCV技术无须制作专门的绝缘层,降低了工艺复杂度和加工成本。
目前,TGV、TCV及相关技术在光通信、射频、微波、微机电系统、微流体元器件的2.5D集成领域有广泛的应用前景。


