5.4 先进封装的特点和SiP设计需求
5.4.1 先进封装的特点
1.先进封装“重内不重外”
先进封装的关注点与传统封装有所不同,传统封装“重外不重内”,先进封装“重内不重外”。
传统封装的关注点更多是引脚排布和引出方式,如TO、DIP、SOP、SOJ、PLCC、QFP、QFN、PGA、LGA、BGA等,这些都是封装的外在表现形式,这是因为传统封装内部基本没有集成的概念,内部缺少变化。Bond Wire、TAB和Flip Chip是传统封装中芯片的3种连接方式,模式比较固定。所以我们可以说,传统封装“重外不重内”。
与传统封装多种多样的外在表现形式不同,先进封装基本都采用BGA类型的封装形式,其外部缺少变化,因而关注点不多。先进封装内部集成的方式多种多样,可研究的技术和问题很多,其主要目的在于提升封装内的功能密度。所以我们可以说,先进封装“重内不重外”。
2.先进封装生产和芯片制造的融合
传统封装都是在芯片生产完成后再进行封装和测试,所以封测行业是一个比较独立的行业。到了先进封装,封装生产和芯片制造融合度提高。主要体现在以下几方面:① 晶圆在切割之前就进行封装,如FIWLP,FOWLPD等;② 封装需要在硅片上有更多的加工工艺,如RDL、TSV等;③ 传统芯片厂商加入先进封装产业链,如TSMC、Intel、SAMSUNG等。
3.先进封装设计和芯片设计的交互
传统封装设计比较独立,通常是在芯片设计完成后,芯片的引脚位置和信号定义确定后再进行封装设计。因为传统封装中没有集成的概念,所以传统封装设计的主要任务是将芯片引脚与封装引脚连接,为信号分配合理的封装引脚,并分配电源和地,以保证信号有良好的质量。
先进封装设计阶段经常与芯片设计阶段有所重合,在进行先进封装设计时,芯片的引脚位置和信号定义还没有完全固定,芯片I/O接口可以和封装协同设计并优化,因此先进封装设计与芯片设计的交互性比较强,这对先进封装的设计工具也提出了相应的要求。目前全球三大EDA厂商都推出了针对先进封装设计的工具套件。
4.先进封装是提升系统功能密度的最重要途径
传统封装因为没有集成功能,系统功能密度的提升主要依靠芯片集成度的提升,封装对系统功能密度的贡献是通过不断缩小封装的尺寸来实现的。
先进封装除了可以获得极小的封装尺寸外,封装内集成的方式灵活多样,包括2D、2.5D、3D等方多种集成方式。在芯片内部集成度已经接近极限的今天,封装内集成是提升系统功能密度重要途径,受到了芯片厂商与系统厂商的重点关注。
5.4.2 先进封装与SiP的关系
先进封装技术有两大发展方向:一种是晶圆级封装(WLP),在更小的封装面积上容纳更多的引脚;另一种是系统级封装(SiP),整合多种功能芯片于一体,可压缩模块体积,提升系统整体功能性、性能和灵活性。
广义上来讲,SiP属于先进封装,但他们涵盖的范围又有所不同,图5-28所示为先进封装(HDAP)与SiP的关系,可以看出HDAP与SiP既有共同涵盖的区域,又有各自不同的覆盖区域。
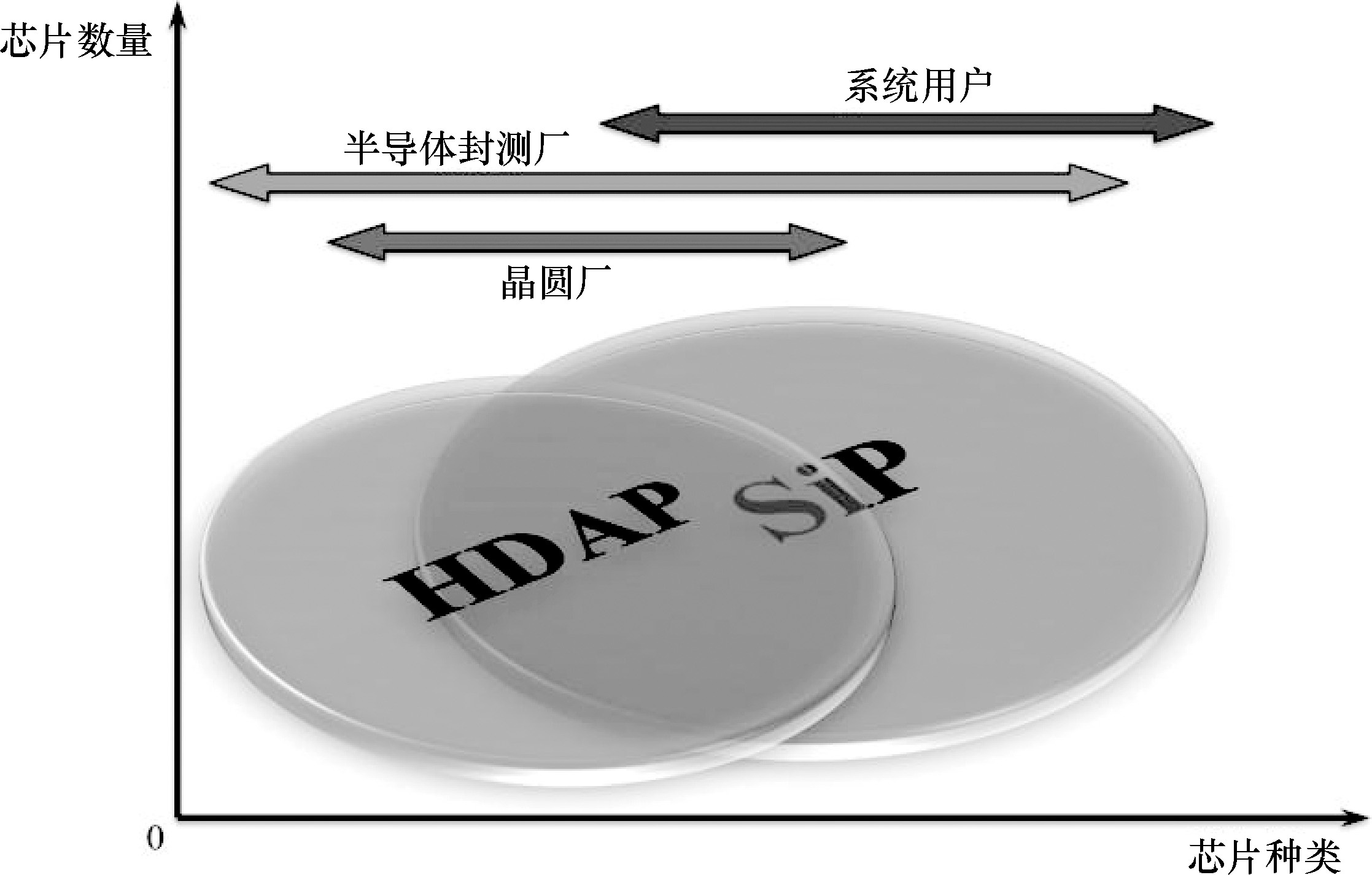
图5-28 先进封装(HDAP)与SiP的关系
HDAP涵盖了单芯片封装,如WLCSP;SiP则均为多芯片封装,SiP中包含的芯片种类和芯片数量比先进封装更多,工艺灵活度也更高。例如,SiP中可能包含键合线、倒装焊、RDL、TSV的混合工艺,而先进封装一般不包含键合线等传统工艺。
通常来说,先进封装更强调工艺的先进性,InFO、CoWoS、HBM、HMC、EMIB、Foveros都采用了先进工艺,属于先进封装技术,先进封装的四要素RDL、TSV、Bump、Wafer至少具备一到两个。而SiP则更强调系统功能的实现,只要是在一个封装中封装了多个裸芯片并实现了相应的系统功能,就可称之为SiP,对工艺的先进性并不做过多强调。
因此,HDAP和SiP有共同涵盖的区域,但它们又有各自的特点。
从晶圆厂到半导体封测厂,再到板级电路装配运营商,半导体的整个产业和供应链对于HDAP和SiP的关注点有所不同。晶圆厂关注HDAP中密度最高、工艺难度最高的部分;半导体封测厂的关注面比较广泛,从单芯片的WLCSP到SiP都有所关注;系统用户则对SiP关注较多。
5.4.3 先进封装和SiP设计需求
最后,根据先进封装的特点总结先进封装和SiP的设计需求。
(1)跨设计领域(芯片设计、封装设计、PCB设计)互连规划,可视化的网络优化,支持Die-Interposer-Package-PCB四级网络连接优化;
(2)支持输入多种数据格式来创建芯片和封装库,同时支持参数化快速创建封装库;
(3)支持多种复杂工艺,支持3D TSV、2.5D TSV和RDL设计,支持Wire Bonding、FlipChip、Cavity和Die Stack设计;
(4)支持复杂层叠结构、盲埋孔工艺和高密度多层互连,支持浆料电阻、电容综合工具,用于自动生成可印刷的无源元器件,支持基板埋置芯片设计;
(5)具备优秀的3D设计环境,支持3D环境和2D环境的实时同步更新、3D元器件布局操作、3D测量、3D DRC检查、3D数据输入输出,数字化样机模拟等功能;
(6)先进的仿真验证平台,支持SI、PI、热仿真分析,支持先进的工艺验证功能。
以上6点功能需求是基于先进封装及SiP的特点得出的设计需求总结。
具体设计工具能否满足设计需要,则需要读者仔细阅读本书的第2部分(本书第6章至第21章)内容。此外,本书的第3部分“项目和案例”,通过实际案例详细介绍了SiP及先进封装产品的设计、仿真和验证方法,具有很强的参考价值。


