6.6 SiP仿真验证流程
本书第2章提出了Si³P的概念,并指出Si³P中的第二个“i”代表interconnection(互联)。互联的目的是进行信息或能量的传递,对于SiP来说,互联主要可分为三个领域:电磁互联、热互联和力互联。
SiP中的仿真也主要围绕这三方面开展,即电磁仿真、热学仿真和力学仿真。
6.6.1 电磁仿真
本书第4章将SiP中的集成分为2D集成、2D+集成、2.5D集成、3D集成、4D集成、腔体集成和平面集成7种方式,这些集成方式都可以很完美地在设计工具Layout 301和XPD中实现。
仿真工具一项重要的功能就是识别设计工具中构建的物理互联模型,并将其正确导入仿真工具,这通常是在仿真开始时就需要实现的。
1.针对平面设计(Planar Design)
这里不采用2D集成设计的说法而采用平面设计的说法,是因为它们的定义所包含的范畴有些不同,2D集成设计中包含2D Bond Wire和2D Flip Chip两种类型,其中2D Bond Wire虽然在集成上来讲属于2D,但在电气互连方面由于有了Bond Wire,所以其对仿真工具来说实际是非2D的。2D Flip Chip和Embedded Passive都位于基板上或者基板内,所以使用2D仿真工具就可以很好地处理。图6-20所示为2D集成设计和平面设计的范畴。

图6-20 2D集成设计和平面设计的范畴
针对平面设计,可以采用HyperLynx SI/PI/Thermal工具进行仿真分析。该工具包含三个模块:① 信号完整性分析工具HyperLynx SI;② 电源完整性分析工具HyperLynx PI;③ 热分析工具HyperLynx Thermal。三个模块位于同一个软件环境中,可以进行协同仿真,如SI-PI协同仿真和电热协同仿真。
HyperLynx SI支持信号完整性、串扰和EMC仿真分析,支持示波器(常规、眼图方式)、频谱仪显示方式。HyperLynx SI内嵌了FCC、CISPR和VCCI三种国际通用的EMC标准,并且支持用户定义自己的标准,HyperLynx SI还内嵌了DDRx和SerDes的分析向导,专门用于DDRx和SerDes的分析。
电源完整性分析工具HyperLynx PI可支持直流压降、交流去耦和平面噪声分析,支持2D和3D波形显示。
HyperLynx Thermal可支持热分析、与HyperLynx PI联合做电热协同分析。
图6-21显示了针对平面设计的仿真流程,可以直接将设计数据传递到HyperLynx进行SI/PI/Thermal分析。

图6-21 针对平面设计的仿真流程
2.针对非平面设计(No-Planar Design)
大多数SiP和先进封装设计是非平面设计,如2D Bond Wire、2D+、2.5D、3D、4D以及腔体集成设计均是非平面设计,此类设计需要用到3D电磁场仿真工具HyperLynx Advanced Solver。
HyperLynx Advanced Solver包含3个解算器:Fast 3D、Full Wave和Hybrid。Full Wave Solver HPC可以看作Full Wave Solver的高性能版本,每个解算器的功能都有所不同,将设计数据导入HyperLynx Advanced Solver,然后采用不同的解算器得到RLGC、S-Parameter、Z-Parameter、Currenty Density、IR Drop、EMI/EMC等,图6-22所示为针对非平面设计的仿真流程①。
如果需要查看信号的时域仿真波形或者眼图,可将将通过Full Wave Solver得到的网络S-Parameter模型与芯片的IBIS模型一起放到HyperLynx SI中进行信号完整性仿真,即可得到时域仿真波形或者眼图。针对非平面设计的仿真流程②如图6-23所示。

图6-22 针对非平面设计的仿真流程①

图6-23 针对非平面设计的仿真流程②
6.6.2 热学仿真
对于平面设计,HyperLynx Thermal可以进行热分析,在早期对SiP设计中的热问题进行诊断,避免SiP产品中出现过热或热失效的问题。
对于非平面设计或者比较复杂的设计,则需要用专业的热分析工具FloTHERM进行热分析,FloTHERM可以支持从平面到非平面各种复杂的设计,FloTHERM仿真流程如图6-24所示。

图6-24 FloTHERM仿真流程
FloTHERM专注于电子器件/设备散热分析,是业界最早针对电子器件/设备散热分析和优化的软件,求解电子设备热传导、对流及辐射三种传热方式,具备丰富强大的经验数据积累,可预测产品内部气流流动、温度分布及热量传递过程。
FloTHERM全方位覆盖多尺度散热问题,支持封装级(IC器件、LED)、板级和模块级(PCB、电源模块)、系统级(机箱、机柜及舱)、环境级(机房、外太空等)的热分析。
6.6.3 力学仿真
力互联(Interconnection of Force)需要考虑来自SiP外部的力和内部产生的力。
对于SiP设计师来说,对力互联主要的关注点是不同元器件或不同材料间的接触面。外部的力主要来自冲击、震动和加速度等。内部的力主要来自相对的形变,产生相对形变最主要的原因是温度的变化。
Mentor提供了力学仿真工具Xpedition DfR,Xpedition DfR可提供震动分析和加速度分析,主要对外部的力造成的影响进行分析。其中震动分析可给出震动引起的可靠性/失效预测,给出失效频率、元器件级别的应力,以及包含六自由度震动仿真;加速度分析可给出一定加速度下的安全系数、引脚级别的Von-Mises应力、详细的应力应变图,以及3自由度力矢量。
不过目前该工具功能还具有一定的局限性,仅能支持SiP的平面集成设计和PCB设计,图6-25所示为平面集成设计的Xpedition DfR力学仿真流程。
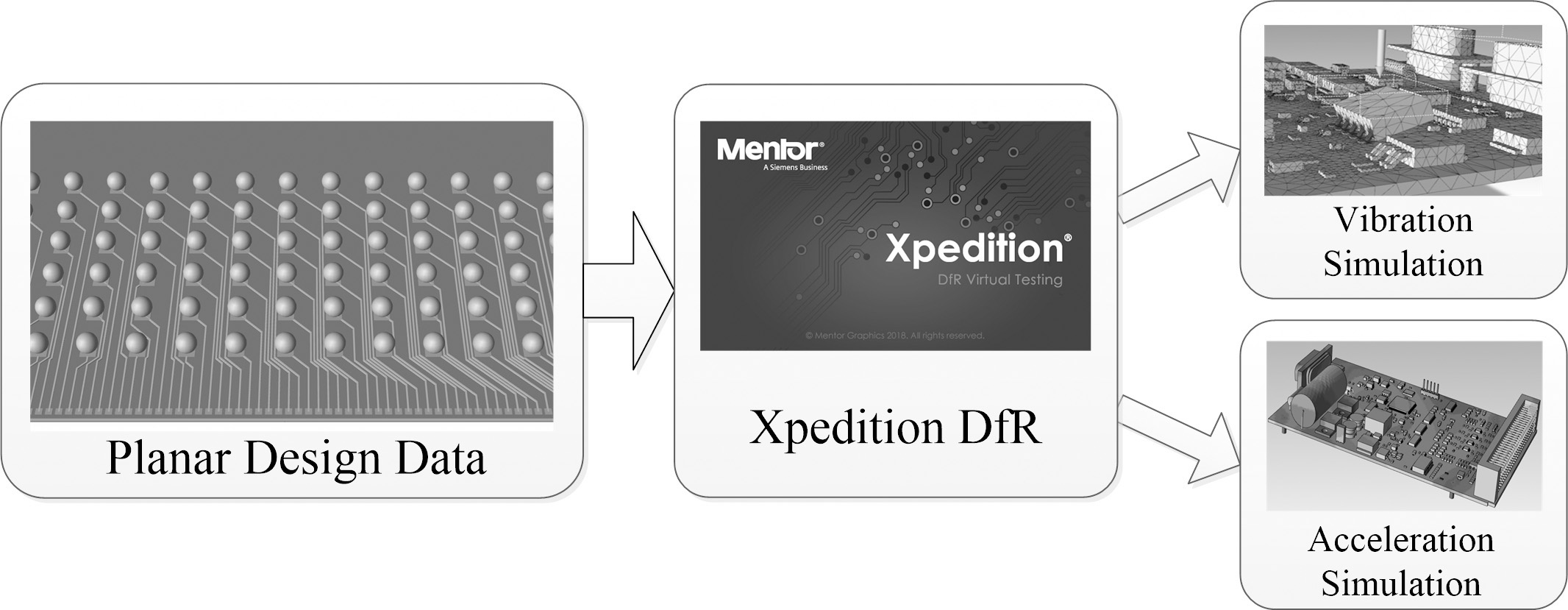
图6-25 平面集成设计的Xpedition DfR力学仿真流程
如果设计师有更多的力学仿真需求,则需要借助第三方的力学仿真工具,如SIEMENS Simcenter或ANSYS等。
6.6.4 设计验证
1.电气验证
电气验证不同于仿真工具,电气验证是以经验规则对设计进行检查的,电气规则检查工具HyperLynx DRC内嵌5大类总共82种电气规则:Analog(3种)、EMI(18种)、PI(10种)、SI(43种)、Safety(8种),这些规则分别对不同方面进行验证。图6-26所示为HyperLynx DRC电气验证流程。
HyperLynx DRC分析的核心是先进的物理和电气规则检查器,基于物理和电参数验证设计、测定问题的区域,结合所允许使用的工具进行全面的Analog、EMI、PI、SI、Safety分析。强有力的API能够创建复杂的规则检查,包括基于频率可改变的物理规则参数。验证结果也能进行交互探测,快速地定位问题,并且可以与SiP版图设计工具进行交互,快速修改设计数据中的错误。

图6-26 HyperLynx DRC电气验证流程
2.物理验证
版图设计工具Layout 301和XPD内嵌的DRC检查工具可以帮助设计师对传统的封装和SiP进行检查和验证。
对于先进封装HDAP中的3D和2.5D集成设计,则需要有专门的验证工具,Calibre是业界最具影响力的IC版图验证工具,由于IC设计和HDAP设计的融合性,以及3D和2.5D集成都需要在硅材料上进行布线(RDL)和打孔(TSV),Calibre专门针对3D和2.5D集成设计开发了Calibre 3DSTACK,其中包含6个功能模块。Calibre 3DSTACK物理验证流程如图6-27所示。
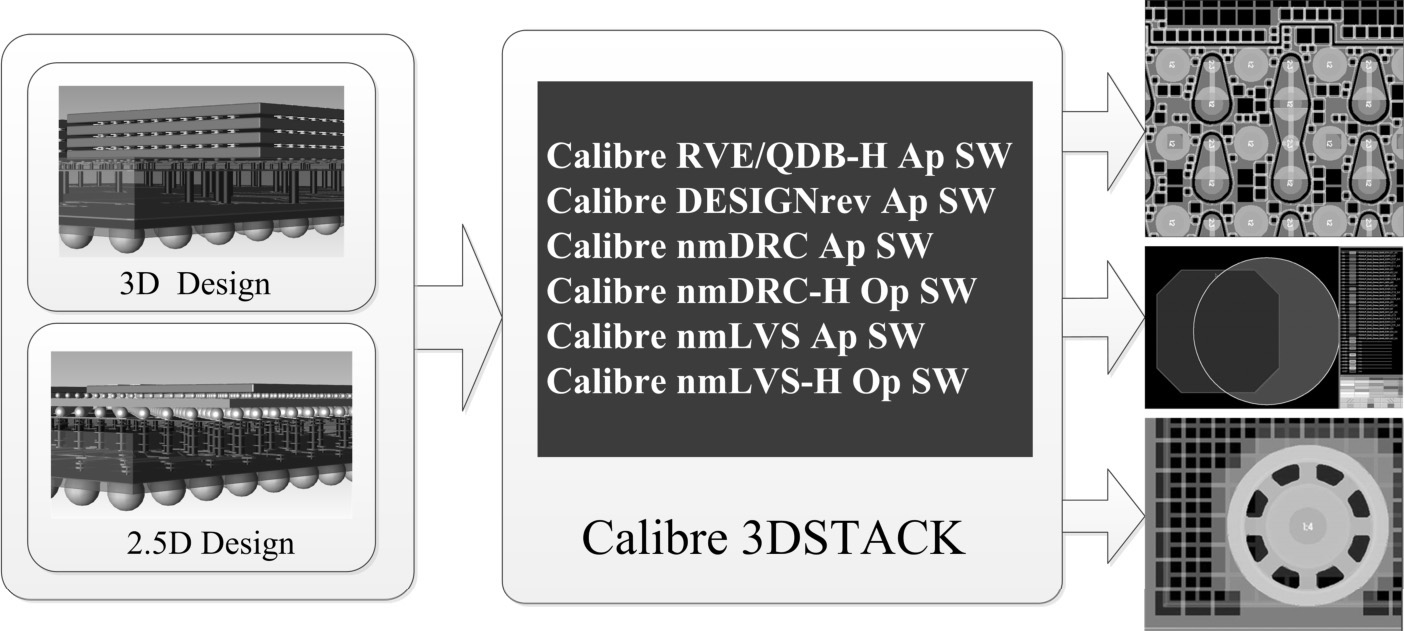
图6-27 Calibre 3DSTACK物理验证流程
Calibre 3DSTACK具备功能强大的图形化调试和结果观察工具RVE,可在原理图和版图之间实现交互探测和网表浏览。为了保证芯片成功流片且具有更高的成品率,代工厂商都会依据工艺水平设定众多的设计规则,对版图图形进行约束。进行版图设计必须遵守这些设计规则,由于人为或者工具的因素,不可避免会违反设计规则,要确保设计的质量必须进行DRC验证,确保整个设计都是满足设计规则的。
Calibre 3DSTACK采用层次优化处理的算法,不仅可以提高效率,还可以避免错误地重复输出,确保版图设计和经过验证的电路图连接关系一致,保证最终产品达到预期设计参数。


