6.7 SiP设计仿真验证平台的先进性
通过前面的描述,相信读者已经对SiP及先进封装设计仿真验证平台有了基本的了解。下面从5个方面对SiP设计仿真验证平台的先进性进行总结。
1.先进封装技术的全面支持
先进封装技术能够在最大程度上提升系统的功能密度,因此受到了业界空前的关注。SiP及先进封装设计平台对先进封装技术提供了全面支持,从3D集成、2.5D集成到FOWLP都可以很方便地在设计工具中实现,结合其强大的基板设计功能,使得设计师可以轻松应对复杂的SiP及先进封装设计。具体可参考本书第12章、第13章和第19章内容。
2.传统封装技术的重点优化
传统封装指的是采用传统的工艺(如键合线、芯片堆叠、腔体等工艺)实现的封装,SiP及先进封装设计平台对这些技术进行了全面的优化和提升,例如:Wire Bond模型的定义、Bond Finger的共享、导引线的设置、复杂芯片堆叠的设置、复杂腔体结构的支持,等等。在版图布线方法上,都较之前的版本有了很大程度的提升和优化。具体可参考本书第11章、第12章和第14章内容。
3.多种技术提升集成的灵活度
SiP及先进封装设计平台除了能很好地支持先进封装和传统封装技术,还能够很好地支持如埋入式无源元器件、RF设计、刚柔电路设计、多人实时协同设计等多种技术,这些技术在很大程度上提升了SiP集成的灵活度。例如,埋入式无源元器件可以节省表面安装空间,减少焊点,提升可靠性;RF设计可以将射频电路集成到SiP中,实现RF SiP设计,这在无线通信领域非常普遍;刚柔电路设计能提升微系统集成的灵活度,实现4D集成设计;多人实时协同设计可以提高设计效率,对于复杂、紧急的项目具有独特的优势。具体可参考本书第15章、第16章、第17章及第18章内容。
4.3D设计环境实现数字化样机
源于强大的3D设计环境,SiP及先进封装设计平台在业界处于领先的地位。3D设计的优势并非仅仅体现在给观察者带来直观的视觉感受,更重要的在于对客观事物的精确描述。从每一根键合线中的每一个弯曲,键合线起始点和终止点的形状和工艺选择,Bond Pad相对于芯片的高度的+/-值,到每一个芯片堆叠、腔体、电阻和电容,每一根布线、每一个过孔,每一个Bump和Ball等都能够精准地通过3D模型来展现。
这种精准的描述可以使设计模型与产品实物有一一对应关系,甚至在很大程度上替代实物样机,这就是所谓的“数字化样机”概念。
在强大的3D设计环境下,可以实现数字化样机设计。因为SiP工具对设计规模没有任何限制,因此无论简单还是极其复杂的设计,都可以通过3D化境来展现其数字化样机设计。图6-28所示为通过3D设计环境实现电源模块的数字化样机模拟。
从图中我们可以看出每种元器件精确的模型,如裸芯片、电阻、电容、电感,以及键合线、布线、过孔、BGA Ball等,Substrate和Molding也可以精准地显示,3D环境还包括3D DRC和3D测量功能,基本上可以实现代替实物样机的展示功能。
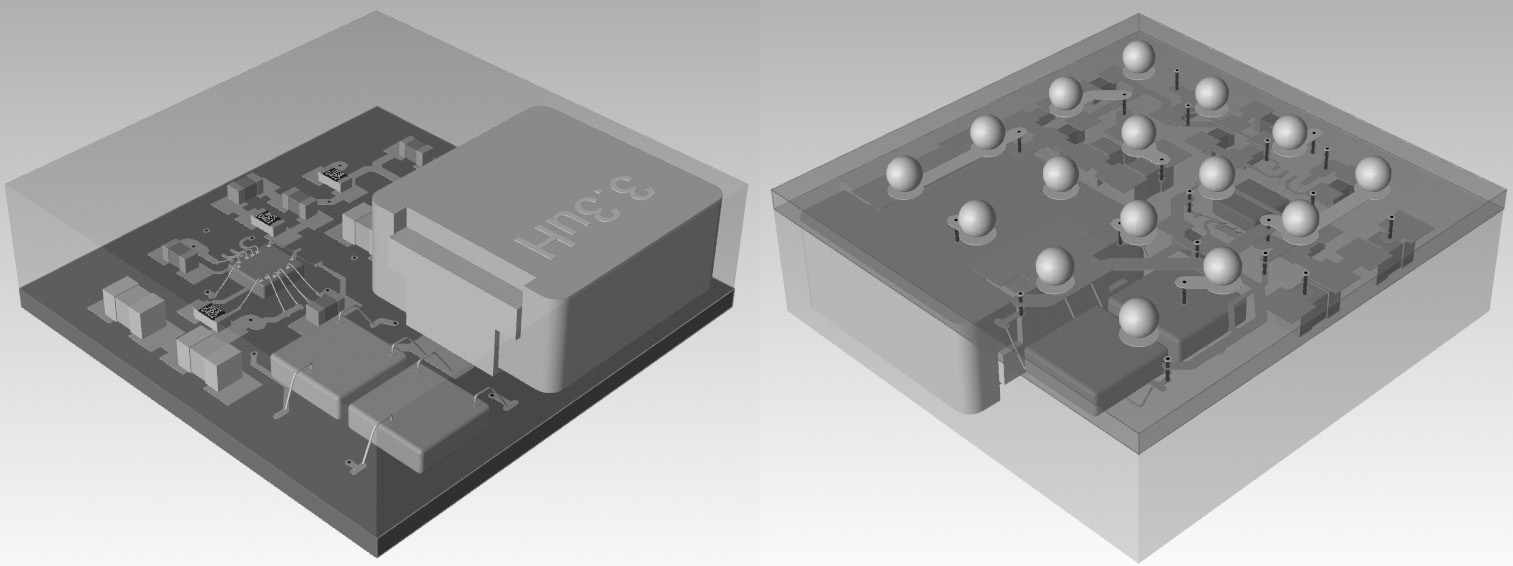
图6-28 通过3D设计环境实现电源模块的数字化样机模拟
除了对所有的设计元素进行精确的模拟,3D设计环境还支持平面切割功能。可以从X、Y、Z三个平面对3D模型进行切割,切割平面可以移动和旋转,从而显示内部元素的精细结构。这一特点超越了实物样机,因为切割实物样机会损坏样机,并且实物样机无法实现在任意平面、任意角度的切割,而数字化样机在这方面则要灵活得多。
同时,3D设计环境支持结构软件的协同设计功能,ECAD-MCAD协同设计使电子产品设计和结构设计可以实时并行。
5.仿真及验证技术保证产品成功
数字化样机只是从静态展示了实物产品的形态,如果需要模拟产品实际工作状态,则可以借助仿真工具。
目前,SiP仿真验证平台可以支持从电磁、热、力三个领域进行全面的仿真分析,模拟实际产品工作时的状态,除了力学仿真功能目前还不够完善,需要借助第三方工具进行全面分析外,SiP仿真验证平台在电磁和热分析方面已经能够解决实际遇到的各种问题。
此外,SiP仿真验证平台独特的电气验证工具HyperLynx DRC和设计物理验证工具Calibre 3DSTACK,从电气和工艺两方面保证了从设计数据到实物产品的一致性,从而最大限度地保证了产品研发的成功。具体可参考本书第21章内容。


